在芯片制造领域,先进制程的影响力和统治力越来越大,已经从之前的逻辑芯片晶圆代工领域,拓展到最先进的存储芯片制造,这在台积电和三星身上有凸出的体现。
当下的3nm制程晶圆代工,台积电的市场统治力很明显,三星处于弱势地位。未来的2nm制程,三星必须加紧赶上,否则会越来越困难。
在高带宽内存(HBM)芯片制造方面,原本都由存储芯片IDM大厂自家完成,但是,到了下一代的HBM4,技术难度和制造难度提高了不少,需要更先进的制程工艺参与进来。
01
2nm制程针锋相对
据报道,台积电将于7月中旬开始试生产2nm制程工艺芯片,早于市场预估的第四季度。
台积电2nm工艺首次应用GAA(全环绕栅极晶体管)技术,可以在更小的制程节点上提供更好的性能。
据台积电介绍,与3nm制程相比,2nm的能效提升10%~15%,功耗降低30%。当试产良率达到一定标准时,便可以推进到量产阶段。
台积电的2nm制程将包括N2、N2P和N2X三个版本,预计2025下半年开始量产其第一代GAAFET N2节点芯片,下一个版本N2P将在 2026年底量产。台积电这两个版本2nm工艺没有使用背面供电技术,不过,整个N2系列将增加台积电新的NanoFlex功能,该功能允许芯片设计人员在同一模块中匹配来自不同库(高性能、低功耗、不同面积)的单元,以提高性能或降低功耗。
N2P之后将是电压增强型的N2X。尽管台积电曾表示N2P将在2026年增加背面供电技术,但看起来情况并非如此,N2P将使用常规供电电路,具体原因尚不清楚。
有消息称苹果已经与台积电达成独家协议,包下台积电2nm制程首批全部产能。
据外媒报告,台积电2024年资本支出可能达到上限值320亿美元,2025年有望进一步升至370亿美元,主要用于提前部署2nm工艺量产,采购先进设备。目前,三星也在发力2nm工艺,台积电提前部署产能的目的是为保持在晶圆代工领域的领导地位。
今年初就有报道称,三星已经从日本人工智能(AI)初创公司Preferred Networks Inc.(PFN)收到2nm制程芯片订单,从而在2nm晶圆代工业务中抢得先机。
7月9日,三星发布公告,官宣了与Preferred Networks Inc.的合作,将基于2nm制程工艺和2.5D封装技术Interposer-Cube S(I-Cube S),提供一站式解决方案,为对方制造AI芯片。
Preferred Networks Inc.主要进行人工智能深度学习开发。据悉,三星之所以被选中,是因为其同时具备存储器和晶圆代工服务,有着较强的综合能力和技术积累,可以提供HBM设计、生产和先进封装的全套解决方案。
三星原计划2025年量产2nm(SF2)制程芯片,然后于2026年采用背面供电技术。与3nm工艺(SF3)相比,三星的2nm工艺性能提升12%,功率效率提升25%,面积减少5%。
台积电和三星在2nm制程芯片量产方面在较劲,双方也都有需要解决的问题。
IBS估计,与3nm处理器相比,2nm芯片成本将增长约50%。
正是有苹果、英伟达、AMD等大客户下单,台积电才会大规模投资最先进制程,否则,像2nm这样烧钱的制程产线,是很难持续支撑下去的。目前,台积电正在全方位控制成本,包括EUV设备的支出,电能的节省等。虽然其它几家厂商也会面临2nm成本问题,但为了追赶台积电,三星和英特尔似乎在成本方面没有台积电那么敏感。另外,由于台积电要在美国新建至少两座先进制程晶圆厂,这给它带来了很多额外的成本压力。因此,台积电的2nm制程产线必须精打细算。
对于晶圆代工来说,良率非常重要,它直接影响生产成本和客户认可度。
自从进入5nm制程时代以来,良率一直是三星晶圆代工业务所面对的最大问题,特别是在3nm制程节点上,三星率先引入了全新的GAA架构晶体管,与以往使用的FinFET晶体管有较大区别,制造难度增加不少。
据Notebookcheck报道,三星的3nm工艺良率在50%附近徘徊,依然有一些问题需要解决。
今年2月,据韩媒报道,三星新版3nm工艺存在重大问题,试产芯片均存在缺陷,良率为0%。报道指出,采用3nm工艺的Exynos 2500芯片因缺陷未能通过质量测试。
为了追赶台积电,三星的3nm制程工艺采取了比较激进的策略,主要体现在GAA晶体管架构上,台积电的3nm依然采用FinFET。2nm才会转向GAA晶体管,激进的结果就是要在良率方面付出一些代价。
02
台积电统治3nm代工
据了解,台积电3nm制程产能已经被各大客户预定到2026年。
最新一波订单正在被联发科和高通争抢。新一轮5G手机旗舰芯片大战将于今年第四季度开打,联发科的天玑9400和高通的骁龙8 Gen 4对决,两大厂商的新处理器都将采用台积电3nm制程生产,近期进入投片阶段,使得相关产能更加紧张,因为英伟达、AMD、苹果都在积极争取更多台积电3nm产能。据悉,台积电计划将今年的3nm制程产能扩充3倍,但仍呈现供不应求的局面。
为了让天玑9400顺利上市,联发科正在努力确保3nm制程产能供应。目前,联发科的旗舰款天玑9300/9300+芯片,都是用台积电4nm制程制造。
高通虽尚未公布新一代旗舰芯片骁龙8 Gen 4亮相时间和细节,外界认为,该款芯片也将采用台积电3nm制程生产,并于第四季度推出,芯片性能也将升级。据悉,骁龙8 Gen 4将采用台积电N3E制程生产,每个芯片报价220~240美元,比骁龙8 Gen 3高出25%~30%。
据悉,台积电打算提高2025年先进制程工艺和先进封装的订单报价,其中,3nm的报价将提高5%以上,具体情况取决于订单的数量和协议条款,目前的晶圆报价在20000美元以上。CoWoS封装的报价将提高10%~20%。传闻台积电的3nm涨价方案已得到客户的同意,双方达成了新协议,以确保稳定的供应。
此外,有业内人士透露,面向高性能计算客户的4nm/5nm制程工艺可能会涨价11%,也就是说4nm晶圆的价格从18000美元提高到约20000美元,比2021年的报价上涨了至少25%。
台积电的3nm、4nm、5nm制程都要涨价,从一个侧面说明三星在这些制程市场上的窘境,因为全球只有这两家能够提供相应制程工艺的量产代工产能,为了追赶台积电,自从7nm制程实现量产以来,很多年,三星都是在低价促销,特别是最先进的3nm制程工艺,比台积电的报价少了很多。如今,竞争对手的产能供不应求,还要涨价,说明三星3nm的客户订单少得可怜,台积电才有底气涨价。
总之,在已经量产的最先进制程方面,台积电优势明显,三星在这方面的竞争力已经很难追赶上,只能寄希望于2nm制程了。
03
台积电要在HBM市场分一杯羹
7月初,据韩国媒体报道,SK海力士将深化与台积电、英伟达的合作,并在9月的国际半导体展(Semicon Taiwan)上,宣布这三家公司更紧密的合作计划。
2022年,台积电在北美技术论坛宣布成立OIP 3DFabric联盟,将存储器与载板合作伙伴纳入,当时,SK海力士资深副总裁暨PKG开发主管Kangwook Lee就透露,该公司一直和台积电在前几代及目前的HBM技术方面紧密合作,以支持CoWoS制程的兼容性与HBM的互连性。SK海力士加入3DFabric联盟之后,通过与台积电更深入的合作,为未来的HBM产品(HBM4)提供解决方案.
据韩国媒体报道,业界消息人士称,SK海力士社长金柱善将于9月在台北举行的国际半导体展上发表专题演讲,这是SK海力士首度参与专题演讲。演讲结束后,金柱善将和台积电高级主管见面,讨论下一代HBM的合作计划,英伟达CEO黄仁勋也可能加入会谈,进一步巩固SK海力士、台积电和英伟达之间的三方联盟。
据悉,三强的合作是在2024上半年敲定的,SK集团会长崔泰源4月会见黄仁勋,讨论了半导体合作事宜,6月,崔泰源拜访了台积电新任董事长魏哲家,以进一步推动后续合作。
SK海力士将采用台积电的逻辑制程,生产HBM的基础接口芯片(base die)。报道称,SK海力士和台积电已同意合作开发并生产HBM4,将于2026年量产。
HBM将核心芯片堆叠在基础接口芯片之上,彼此垂直相接。SK海力士生产的HBM3E产品,采用的是自家制程工艺制造的基础接口芯片,但从HBM4开始,将采用台积电的先进逻辑制程。报道称,SK海力士将在论坛上介绍合作成果,据悉,HBM4的功耗比原本目标还低20%以上。
自从HBM问世并量产以来,SK海力士一直是英伟达为其AI GPU配备该类内存的独家供应商,发展到HBM3E版本,依然如此,只是从2024年第二季度开始,另外两家内存大厂三星和美光才开始加入英伟达HBM供应链,这两家内存大厂准备花费数十亿美元来扩大HBM芯片生产能力。
不久前,三星推出了其12层堆叠的HBM3E,挑战SK海力士8层堆叠产品的行业地位。三星的一位高管表示,该公司计划今年将芯片产量增加两倍。面对竞争,SK海力士的HBM项目正在提速,预计首批12层堆叠的下一个版本HBM4最快会在2025下半年到来,到2026年还会有16层堆叠的产品,会向更加定制化的方向发展。
HBM3E市场竞争已经落后,希望落在了HBM4上,三星正在加快研发脚步,以缩小与SK海力士之间的差距。在代号为“Snowbolt”的第六代HBM芯片HBM4方面,三星计划将缓冲芯片应用于堆叠内存的底层以提高效率。
正当三星加紧追赶存储芯片竞争对手SK海力士的时候,后者与三星的晶圆代工“死敌”台积电在深化合作。对三星来说,这显然是个坏消息。
5月中旬,在2024年欧洲技术研讨会上,台积电表示,将使用其12FFC+(12nm级)和N5(5nm级)制程工艺制造HBM4接口芯片。
台积电设计与技术平台高级总监表示:“我们正在与主要的HBM内存合作伙伴合作,开发HBM4全栈集成的先进制程,N5制程可以使HBM4以更低的功耗提供更多的逻辑功能。”据悉,N5制程允许将更多的逻辑功能封装到HBM4中,并实现非常精细的互连间距,这对于逻辑芯片上的直接键合至关重要,可以提高AI和HPC处理器的内存性能。
相对于N5,台积电的12FFC+工艺更加经济,制造的基础芯片能构建12层和16层的HBM4堆栈,分别提供48GB和64GB的容量。
台积电还在优化封装技术,特别是CoWoS-L和CoWoS-R,以支持HBM4集成。这些先进的封装技术有助于组装12层的HBM4内存堆栈。据台积电介绍,实验性HBM4内存在14mA时的数据传输速率已达到6 GT/s。
台积电的先进制程工艺能力,以及SK海力士的先进存储芯片制造能力,可以将结构更为复杂的HBM4内存的制造分解开,发挥各自优势,制造出最佳的逻辑接口和DRAM裸片,然后用先进的封装技术将它们组装起来,以最大化地发挥该类内存的性能优势。
对三星来说,在先进制程晶圆代工市场被台积电压制,但作为存储芯片龙头企业,三星还是很自信的。如今,台积电与自己的主要竞争对手SK海力士在内存领域深度合作,简直是在抄三星的后路。要发展HBM4,就绕不开先进的逻辑芯片制程工艺,如果三星的晶圆代工业务短期内做不好这些的话,恐怕也躲不开找台积电合作的选项。

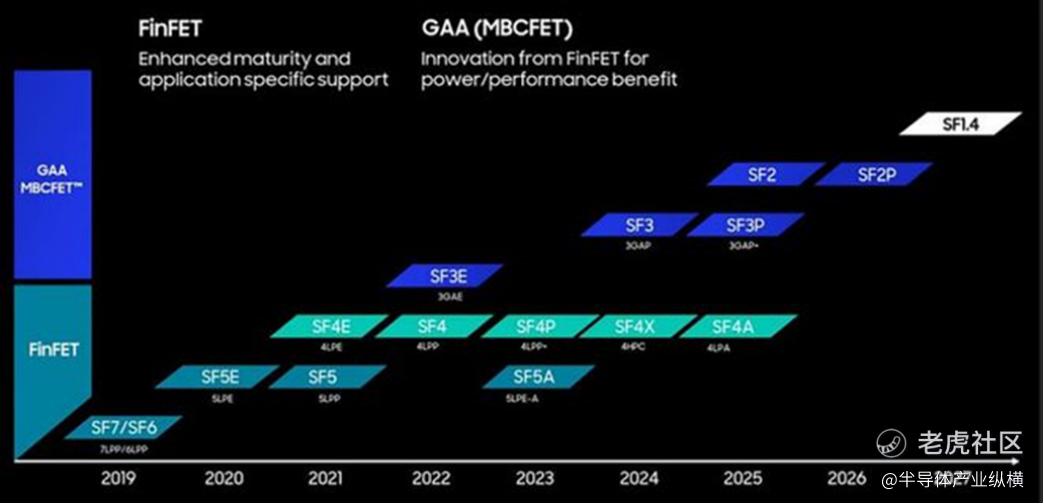
精彩评论